
全部

 1073
1073
 0
0
本发明提供一种存储器芯片位线失效分析方法,用以对包含埋入式位线及金属位线结构的存储器芯片进行位线失效分析,每条所述埋入式位线与相应的所述金属位线之间通过多个位线接触窗相连,所述方法包括以下步骤:去除所述存储芯片的金属位线之上的钝化层、互连金属层及层间介质层,暴露出所述金属位线;通过电测试确定存储芯片上相互之间存在短路的两条金属位线,逐段切割其中的一条金属位线,使得该金属位线中连接于相邻位线接触窗的部分之间均被割断;去除存储芯片的衬底及包含在衬底内的埋入式位线,形成检测样片;对所述检测样片进行电势对比成像观测,确定所述短路金属位线的具体失效位置。

 1140
1140
 0
0
本发明提供一种存储器芯片位线失效分析方法,包括以下步骤:通过机械研磨去除待分析芯片的互连金属层和位线层的大部分;通过机械研磨去除待分析芯片的衬底的大部分;通过湿法刻蚀完全去除待分析芯片的残存的衬底;通过干法刻蚀去除待分析芯片位线接触窗底部的介质层的大部分,保留一薄层的介质层;对待分析芯片的位线接触窗的顶部进行检测,确定位线失效的具体位置。本发明方法可使待分析芯片充分减薄,可直接通过电子显微镜进行观测确定其位线短路失效的具体位置,大大提高了工作效率,节省了时间成本。

 1194
1194
 0
0
本发明涉及一种GOI失效点无损定位方法及GOI失效分析方法,包括步骤1,去除待分析样品的金属互连层,获取具有裸露salicide层的预处理待分析样品;步骤2,基于PVC法,采用电子束照射所述预处理待分析样品的salicide层,并观察其是否发亮;是,则所述待分析样品存在GOI失效点,执行步骤3;否,则所述待分析样品不存在GOI失效点,结束操作;步骤3,将电子束照射时发亮的salicide层切割成多个相对分离的区域;步骤4,再次基于PVC法,采用电子束照射所述区域,并找出所述区域中发亮的salicide层;步骤5,循环执行步骤3和步骤4,直至电子束照射时发亮的salicide层的大小不能进行切割时,结束操作。本发明实现GOI失效点的高精度定位,且整个定位过程不会导致GOI失效点的进一步破坏。
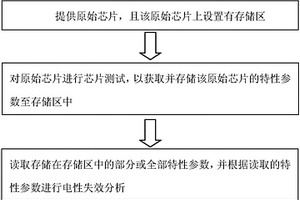
 1139
1139
 0
0
本发明涉及半导体制造技术领域,尤其涉及一种对失效芯片进行电性失效分析的方法,通过在CP测试过程中记录芯片的特性参数,在CP测试最后将收集到的芯片特性参数写入安全寄存器内,并使其变为只读状态,以便于在后续的电性失效分析中,能快速高效得到初始CP中芯片的特性参数,因此一定程度上节约人力和测试机台成本,提高后期对芯片的分析效率。

 793
793
 0
0
本发明实施例公开了一种待失效分析样品的制备方法,所述方法包括:提供封装结构,所述封装结构包括芯片堆叠结构以及覆盖所述芯片堆叠结构的密封剂;所述芯片堆叠结构包括基板,堆叠设置在所述基板上方的多个芯片,及用于使所述多个芯片之间,和/或所述多个芯片与所述基板之间实现电连接的多条导电线;所述多个芯片在所述基板上方依次堆叠形成第一台阶结构,所述多条导电线位于所述第一台阶结构的上方;对所述第一台阶结构上方的密封剂执行多次研磨步骤,以切断所述多条导电线,得到所述待失效分析样品。

 824
824
 0
0
本发明提供一种失效分析样品的制备方法及失效分析样品,制备方法包括如下步骤:提供待分析的堆叠封装体,堆叠封装体中设置有多个堆叠的裸片,每一裸片具有设置焊垫的正面及与正面相对的背面,裸片的背面与其相邻的裸片的正面接触,所述裸片的焊垫与其相邻的裸片的焊垫电连接;去除目标裸片背面的其他裸片,至暴露出与所述目标裸片相邻的裸片的焊垫时停止;将暴露的焊垫电学引出,形成用于失效分析的样品。本发明优点是,对目标裸片背面进行去除操作,且利用非目标裸片焊垫作为电连接处,从而避免对目标裸片具有电路器件的正面进行去除操作,保护了正面的电路器件,能够制备出完整无损伤的目标裸片,大大提高了制样成功率,大大降低了制样难度。

 1232
1232
 0
0
本公开实施例公开了一种失效分析样品的制作方法。所述方法包括:提供待测管芯;其中,所述待测管芯包括相对设置的正面和背面,所述待测管芯的正面通过第一胶层与第一基板之间粘接;将所述待测管芯的背面通过第二胶层与第二基板固定连接;其中,所述第二胶层的固化温度小于所述第一胶层的熔化温度,所述第二胶层的熔化温度大于所述第一胶层的熔化温度;在所述待测管芯的背面粘接有所述第二基板后,分离所述第一基板和所述待测管芯。

 935
935
 0
0
本申请实施例公开了一种透射电镜试样及其制备方法、待测结构的失效分析方法,其中,所述透射电镜试样的制备方法包括:在待测结构中确定测试区域;在测试区域中确定待分析结构和待去除结构,所述待分析结构沿第一方向的两端分别与所述测试区域的边缘具有第一预设距离,所述待去除结构位于所述待分析结构沿第二方向的投影区域内,所述待分析结构朝向所述第二方向的侧面与所述待去除结构接触,所述第一方向与所述第二方向之间的夹角大于0°且小于180°;去除所述待去除结构,并保留在第一方向上位于所述待去除结构两侧的至少部分所述测试区域作为支撑结构,得到透射电镜试样,其中,所述支撑结构与所述待分析结构形成一体成型的至少一个U型支架。

 1069
1069
 0
0
本发明提供了一种对封装芯片进行测试及失效分析的方法,对封装芯片靠近金球的一面进行第一次研磨,至暴露出所述金球,从而可以采用探测板通过金球对所述封装芯片进行探针测试;对封装芯片靠近硅衬底的一面进行第二次研磨,至暴露出所述硅衬底,从而可以采用红外定位的方法确定封装芯片的失效点,避免了现有技术中高温和化学腐蚀对封装芯片的影响或破坏,提高对封装芯片进行失效分析的准确性及效率。

 891
891
 0
0
本申请公开了一种字线电阻测试方法及三维存储器失效分析方法,其中,所述字线电阻测试方法首先将三维存储器的第一台阶区和第二台阶区的多根通孔连线暴露出来,然后通过在第一台阶区形成连接金属层的方式,将多根字线通过通孔连线和连接金属层连接起来,最后通过在第二台阶区测试每两根待测连线的电阻,并根据测试获得的第一测试电阻、第二测试电阻和第三测试电阻计算三个所述待测连线的电阻,也即得到了与这三根待测连线对应的字线电阻,从而实现了对三维存储器中字线电阻的测量,为对三维存储器进行失效分析奠定了基础。

 718
718
 0
0
本发明公开了一种管芯失效分析方法及堆叠封装芯片失效分析方法,管芯包括衬底以及位于衬底上的器件层,失效分析方法包括:从管芯的背面,即衬底所在面,对管芯中的缺陷进行热点定位;从管芯的背面,去除衬底以暴露目标线路;以及在管芯的背面进行电测量以获得缺陷的信息。堆叠封装芯片包括引线框、堆叠于引线框上的多个管芯、以及覆盖引线框和多个管芯的封装料,失效分析方法包括:对堆叠封装芯片进行电测量以确定故障管芯;若存在未进行失效分析的故障管芯,则重复执行失效分析步骤;失效分析步骤包括:去除引线框、封装料的一部分和/或管芯,直至暴露出首个未进行失效分析的故障管芯的衬底;采用管芯失效分析方法对故障管芯进行失效分析。
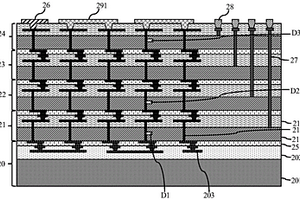
 1010
1010
 0
0
本发明提供了一种半导体测试结构及半导体器件的失效分析方法,通过晶圆键合结构的顶部的测试焊盘和外接焊盘对至少位于所述晶圆键合结构的顶面晶圆和底面晶圆之间的每个晶圆均进行电性测试,以检测出失效的晶圆;以及,对所述失效的晶圆进行失效分析,以定位出晶圆键合结构中的失效的晶圆中的失效点,使得至少能够测试出晶圆键合结构的顶面晶圆和底面晶圆之间的晶圆是否失效以及测试出失效的晶圆中的失效点,进而使得能够快速且准确的定位多片晶圆键合的结构中的失效晶圆以及失效点,提高了失效分析的效率和成功率。
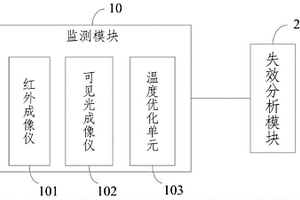
 1048
1048
 0
0
本发明提供刀具失效过程实时检测及优化数据分析系统,包括监测模块和失效分析模块;所述监测模块,用于实时获取刀具工作过程中刀具的纹理特征值和温度特征值;所述失效分析模块,用于基于已训练的刀具失效模型对所述纹理特征值和温度特征值进行处理,得到刀具失效状态。通过测试和提取刀具红外信号特征样本,断精度可达到80%以上,有效解决了刀具工作状态难以实时监测与诊断的技术难题,对提高刀具的工作效率以及节能降耗具有非常重要的意义。
中冶有色为您提供最新的湖北有色金属失效分析技术理论与应用信息,涵盖发明专利、权利要求、说明书、技术领域、背景技术、实用新型内容及具体实施方式等有色技术内容。打造最具专业性的有色金属技术理论与应用平台!
 2025年10月15日 ~ 17日
2025年10月15日 ~ 17日  2025年10月17日 ~ 19日
2025年10月17日 ~ 19日  2025年10月23日 ~ 25日
2025年10月23日 ~ 25日  2025年10月31日 ~ 11月02日
2025年10月31日 ~ 11月02日  2025年11月07日 ~ 09日
2025年11月07日 ~ 09日 
