
全部
▼
热搜:
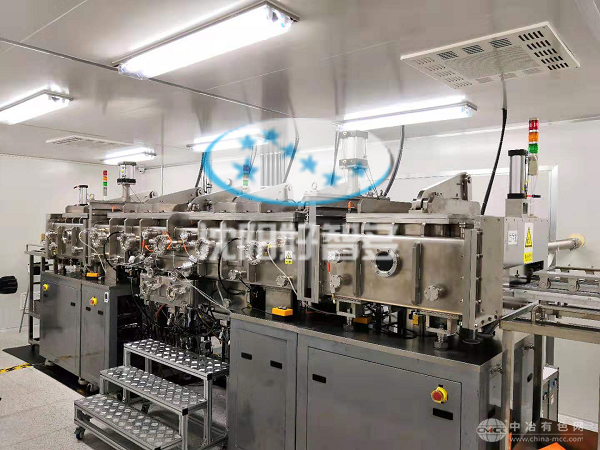
 1027
1027
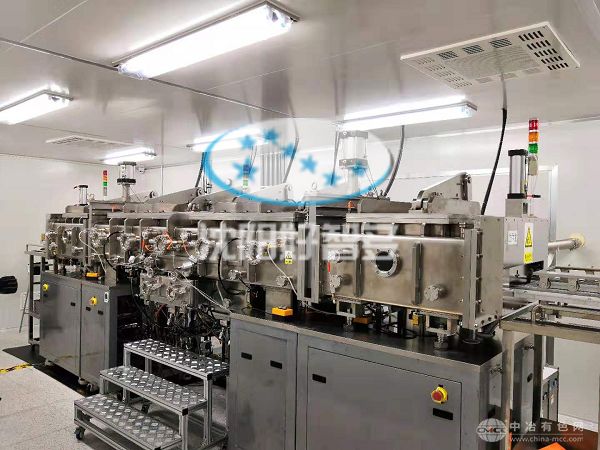
设备用途
主要用于在硅片(或玻璃片)表面制备金属薄膜(A I 、Ag 、Ni 、Cu、Ti 、Pd等),及有机薄膜,并能升级实现反应溅射。模块式设计,可根据实际需求和功能,组合成型。
主要技术指标:
真空指标极限真空度:≤8x10-6Pa (经烘烤除气后);
系统真空检漏漏率:≤5.0x10-7 Pa.l/S;
系统短时间暴露大气并充干燥氮气后,再开始抽气,40分钟可达到6.6x10-4 Pa;
停泵关机12小时后真空度:≤15Pa;
真空室真空室为带冷却水道的方形真空室,壁挂防污板,选用优质不锈钢材料制造,氩弧焊接,表面进行特殊工艺抛光处理,接口采用金属垫圈密封或氟橡胶圈密封。
磁控靶矩形靶材尺寸约450 X 75 mm, 靶上面有一套自动挡板;射频溅射与直流溅射兼容,靶内有水冷;
蒸发源有机蒸发源、金属蒸发源可选
样品最大300 mm X 300 mm玻璃片或硅片,加热最高温度 350°C±1°C;
真空获得及测量分子泵+机械泵或冷泵+干式泵,数显复合真空计(皮拉尼规+电离规)
配套电源直流电源、射频电源、直流脉冲电源
气路三路进气,质量流量计控制
控制系统 手动或自动
工作压力控制系统手动或自动
水冷机组可选





