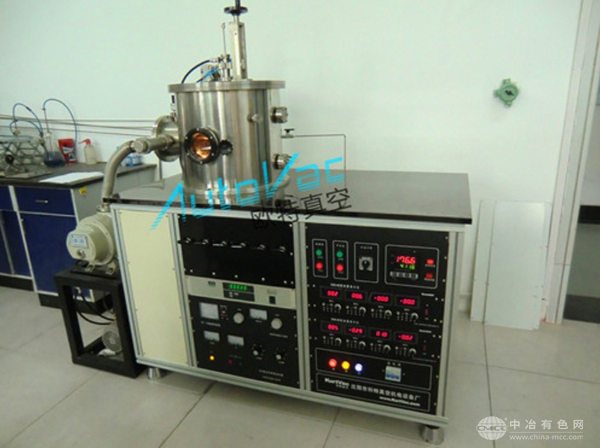
等离子体增强化学气相沉积PECVD
等离子体增强化学气相沉积(PECVD)是一种在冶金和材料科学领域广泛应用的技术,它通过利用等离子体的活性来增强化学反应速率,实现高质量薄膜的沉积。这种设备在制备高性能的金属和非金属薄膜方面具有重要作用,尤其是在需要精确控制膜厚、成分和结构的应用中。
等离子体增强化学气相沉积PECVD设备主要由高真空获得与测量系统、样品台、平行板式辉光等离子体电极系统、气路系统及电气控制系统等五部分组成。高真空机组采用复合分子泵和机械泵组成,确保了极限真空度达到≤6.7×10^-5Pa,漏率≤10^-7 Pa•L/s,为PECVD过程提供了理想的高真空环境。大面积样品台,衬底可加热,平行板式辉光等离子体电极Ø400,可在线升降,这些设计使得设备能够处理各种尺寸和形状的样品,适用于多种材料的薄膜沉积。
一、 设备主要功能及组成
1. 设备主要由高真空获得与测量系统、样品台、平行板式辉光等离子体电极系统、气路系统及电气控制系统等五部分组成。
2. 高真空机组采用复合分子泵和机械泵组成。
3. 大面积样品台,衬底可加热。
4. 多种工艺气体可选,气路系统定制。
5. 可选配膜厚控制仪,进行在线测量和监控。
6. 电气控制系统具有多种报警功能,能及时提示故障情况,保障设备安全运行。
二、 主要技术参数
1. 真空室尺寸:Ø450×450(可定制)
2. 极限真空度:≤6.7×10-5Pa
3. 漏率:≤10-7 Pa•L/s
4. 样品台:可旋转、衬底加热
5. 平行板式辉光等离子体电极:Ø400,可在线升降
6. 气路系统:定制(采用高精度MFC质量流量控制器)
7. 可选配工艺系统:手套箱工作站、样品预处理室、自动样品库等
8. 供电电源:380V 50Hz(三相五线制)
9. 进水排管径:DN25
10. 工作水压:0.2Mpa


 682
682