
硅片厚度测量
简要描述:硅片厚度测量仪采用的是近红外光(NIR)来测量膜层厚度,因此可以测试一些肉眼看是不透明的膜层(比如半导体膜层)。
硅片厚度的测量方法也有多种,常见的包括:
1、光学显微镜法:通过光学显微镜观察硅片的表面,利用尺度刻度或者测距尺来测量硅片的厚度。
2、原子力显微镜法:利用原子力显微镜对硅片表面进行扫描,可以直接测量硅片的厚度。
3、椭偏测量法:利用硅片对偏振光的旋光效应,通过测量光的偏振态变化来确定硅片厚度。
4、X射线荧光光谱法:通过X射线荧光光谱仪测量硅片的元素成分,从而间接推断硅片的厚度。
5、激光测量法:利用激光测量仪器对硅片表面进行扫描,通过测量激光的反射或散射来确定硅片的厚度。
6、超声波测量法:通过超声波测量仪器对硅片进行超声波传播速度的测量,从而计算硅片的厚度。
不同的方法适用于不同的硅片厚度范围和精度要求,具体选择取决于实际需求和实验条件。
满足薄膜厚度范围从15nm到3mm的先进厚度测试系统
F3-sX家族利用光谱反射原理,可以测试众多半导体及电解层的厚度,可测最大厚度达3毫米。此类厚膜,相较于较薄膜层表面较粗糙且不均匀,F3-sX系列配置10微米的测试光斑直径因而可以快速容易的测量其他膜厚测试仪器不能测量的材料膜层。而且能在几分之一秒内完成。
波长选配
F3-sX采用的是近红外光(NIR)来测量膜层厚度,因此可以测试一些肉眼看是不透明的膜层(比如半导体膜层)。980nm波长型号,F3-s980,专门针对低成本预算应用。F3-s1310针对于高参杂硅应用。F3-s1550则针对较厚膜层设计。

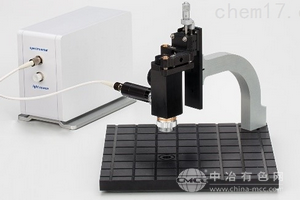
 592
592 






